近年来,随着电子信息产业的快速发展,集成电路用溅射靶材也得到了较大发展。用于制造半导体芯片的金属靶材中,常见的溅射靶材有Ta、Ti、Al、Co和Cu等有色金属。其中集成电路制造用金属溅射靶材中用量最大的是超高纯铝[>99.999%]和超高纯铝合金靶材,用来溅射阻挡层的是超高纯钛靶材。在大规模集成电路中,金属互连电迁移为主要失效机制之一。在大电流密度下,铝线易发生电迁移导致铝互连线薄膜上形成突起和空洞,从而降低集成电路的运行效率和可靠性。Cu的电阻率要比Al约低35%,抗电迁移能力也较强;并且随着集成电路的高度规模化发展,集成化程度越来越高,对用于制造互线和阻挡层的溅射靶材提出了更高的技术要求,在深亚微米工艺中[≤0.18μm],铜将逐步代替铝成为硅片上金属化布线的材料,超高纯铜靶材得以更多的应用,与之相应的用来溅射阻挡层的是高纯钽靶材
随着作为溅射阻挡层镀膜材料的高纯钽靶材用量增大,其对靶材性能要求也越来越高,如要求溅射靶材尺寸越来越大,微观织构越精细均匀等。因此对于溅射靶材的制备工艺研究也逐渐受到关注B,目前,高纯钽溅射靶材的制备工艺主要有熔炼铸锭法和粉末冶金法。通过介绍上述两种工艺制备产品的特点以及目前国内外生产现状等,为广大科研工作者提供参考。
1、高纯钽溅射靶材制备工艺
1.1熔炼铸锭法制备高纯钽溅射靶材
熔炼铸锭法是目前制备钽溅射靶材的主要方法,一般是将钽原料进行熔炼[电子束或电弧、等离子熔炼等]、铸造,将得到的锭或坯料反复进行热锻、退火,再进行轧制、退火,精加工后而成靶材。生产工艺流程如图1所示。锭或坯料经过热锻破坏铸造组织,使气孔或偏析扩散、消失,再通过退火使其再结晶化,从而提高组织的致密化和强度。

为保证靶材能够溅射高质量的薄膜,一般对钽溅射靶材有很高的纯度要求,通常靶材纯度越高,薄膜质量相对越好。如在集成电路上使用时,由于铀和钍有α衰变,α粒子会造成半导体材料中器件电击穿,要求铀和钍的含量必须要低于μg/kg级的水平;碱金属钠钾离子易扩散到绝缘层[SiO2]中去,并以电的载体进行活动;铁元素可能会降低器件性能;因此对钠钾杂质、铁元素也有严格要求。气体元素[C、N、O、S等]过高会降低靶材溅射性能,而其它难熔金属元素钨、钼、铌等元素也要求尽量降低。熔炼铸锭法可以制备出高纯或超纯的钽溅射靶材,一般可达4N以上,商用钽靶化学杂质元素分析见表1。
表1商用钽靶[4~5N]化学元素分析表
| 化学杂质 | Fe | Na | Cr | Ni | Si | Mn | Mg | Zr | Al | Cu | U |
| 含量/mg·kg-1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.0005 |
| 化学杂质 | Th | Ti | W | Mo | Nb | Au | Co | C | 0 | N | S |
| 含量/mg·kg-1 | <0.001 | <0.1 | <1 | <1 | <1 | <10 | <0.1 | 10 | 20 | 10 | 10 |
如果制备的钽溅射靶材中含有孔隙,则会极大影响溅射性能,如溅射过程中若是含有气体的孔隙被打通就可能会释放出气体,令溅射过程的瞬间不稳定,甚至产生电弧现象,使得沉积膜均匀性难以保证,因此,钽溅射靶材应保证致密度。通常熔炼铸锭法制备的钽靶材致密度相对较好。
靶材晶粒尺寸和晶粒尺寸的均匀性也是影响靶材溅射性能的重要因素之一。一般来说,熔炼锭或坯料晶粒粗大,通常直径在50mm以上,经过热锻和再结晶退火后,可以得到100μm以下的晶粒。如文献提到,将纯度[除去氧和其它气体杂质]为99.998%以上、高为200mm、直径为200mm、晶粒尺寸为55mm左右的电子束熔炼锭坯料,经反复锻造、轧制、再结晶退火等,可获得平均晶粒尺寸在110μm以下、晶粒直径偏差为±20%以下、且组织均匀、镀膜均匀性较好的钽溅射靶。但是熔炼铸锭法制备靶材,仍存在靶材晶粒尺寸和晶粒织构取向均匀性较难控制的缺点,易产生带状织构,如图2所示。

1.2粉末冶金法制备高纯钽溅射靶材
粉末冶金法制备高纯钽靶材的方法主要有热压、热等静压、冷等静压真空烧结等,工艺流程如图3所示。目前较为常见的粉末冶金制备钽溅射靶材法主要为热压和热等静压法,如有文献中提到,通过将金属粉末表面氮化的方法,可以获得氧含量在300 mg/kg以下,氮含量在10mg/kg以下的钽粉,然后装入模具,再经冷压成型和热等静压成型或其它烧结等方法,可获得纯度为99.95%以上、平均晶粒尺寸小于50μm,甚至10μm,织构随机、且沿靶材表面和厚度方向织构均匀的钽靶。

而对于冷等静压,再进行真空烧结制备高纯钽溅射靶材的方法,文献资料较少,目前尚不成熟,以下是进行的初步探索试验。取平均粒径为8.0μm的钽粉,装入包套模具内。然后进行冷等静压成型,成型压力220 MPa,保压20 min;将成型后的钽坯置于真空炉内进行烧结,烧结温度最高为2100℃,保温6~8h;然后对烧结后钽进行轧制、再结晶退火等,再进行精加工后即为成品。下面从纯度、孔隙度、晶粒尺寸和织构几个方面对靶材成品性能进行分析。
1.2.1纯度
该试验制备的钽靶材化学杂质分析结果见表2。从表2可以看出,同熔炼锭法制备钽靶[表1]相比,该试验制备钽靶的化学杂质含量普遍偏高,尤其是气体杂质“O”含量,远高于商用钽靶中氧元素的含量。作为半导体用溅射靶材,通常要求“O”含量在100 mg/kg以下。而该试验制备的钽溅射靶,较难保证低的气体“O”杂质含量。
表2钽靶材化学杂质元素分析表
| 化学杂质 | Fe | Na | Cr | Ni | Si | Mn | Mg | Zr | Al | Cu |
| 含量/mg·kg-1 | <10 | <10 | <10 | < | <10 | <1 | <10 | 11 | <1 | <1 |
| 化学杂质 | Ti | W | Mo | Nb | Cd | Co | C | 0 | N | S |
| 含量/mg·kg-1 | <1 | <10 | <10 | <10 | <5 | <1 | 70 | 750 | 50 | 7 |
1.2.2晶粒尺寸
靶材的晶粒尺寸及其均匀性对靶材溅射性能有重要影响,极大规模集成电路用半导体溅射靶材要求靶材有合适的晶粒尺寸[小于100μm或更小40μm],并保证其均匀性。该试验方法制备的钽靶材,烧结后晶粒尺寸为60~80μm,经少量加工轧制便可获得超细、均匀性好的晶粒,晶粒尺寸在15~40μm范围内,靶材金相照片如图4所示。因此,粉末冶金法制备钽溅射靶材,更易获得超细、均匀性好的晶粒。
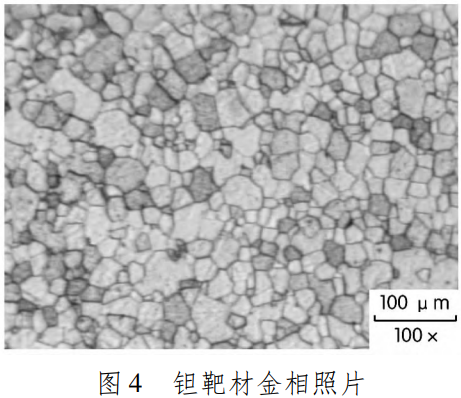
1.2.3孔隙度
试验制备的钽靶材成品相对密度为99.65%,从图4的金相照片来看,尚且没有明显的孔洞,致密度较好。
1.2.4织构
一般来说,靶材织构取向越随机,镀出的膜厚均匀性越好,织构取向越强,镀膜的均匀性越差通过采用EBSD[电子背散射衍射]手段对该试验制备的钽靶材进行分析,如图5所示。其中{111}织构比例为19.6%。由图5可以看出,该钽靶材具有随机、均匀的织构取向,没有带状织构。因此,相比熔炼铸锭法制备钽靶材易产生织构取向,粉末冶金法可避免钽靶中产生强的织构取向现象,更易获得织构随机、均匀性较好的靶材。

随着半导体硅片尺寸的增大,溅射靶材的尺寸也在向大型化发展,为保证溅射过程中靶材的稳定性和利用率,还要求靶材在三维方向上要保持晶粒尺寸和织构的均一,以获得优异的薄膜性能。粉末冶金法制备钽靶材更有利于保证其微观组织的均匀性。该方法其关键在于选择高纯、超细粉末作为原料和能够快速致密化的成型烧结技术,以保证靶材的低孔隙率,控制晶粒度,并且制备过程严格控制杂质元素的引入。而其中的钽粉原料气体杂质[O、C等]含量控制,烧结工序等是其技术难点。
2、国内外现状及展望
我国虽有丰富的原材料,但由于此前全球只有美国、日本具备溅射高纯靶材的生产能力,关键技术及市场一直被国外公司垄断。目前掌握钽靶材制造技术的,主要有日本日矿公司[Nikko]、美国普兰克西公司[Praxair]、美国霍尼韦尔公司[Honeywell]、美国东曹公司[ Tosoh]等四家公司。近年来,国内半导体靶材生产厂家经过努力,也取得了较大的进步,如宁夏东方钽业股份有限公司已获得稳定的高纯钽溅射靶材生产工艺路线。尽管与国外技术还有一些差距,坚信将来一定会突破技术难关,跻身于国际市场。熔炼铸锭法制备高纯钽溅射靶材,可获得高纯或超纯且致密性优良的靶材,这对于获取高性能靶材是非常重要的,因此目前该方法仍是制造钽溅射靶材的主流方法。粉末冶金法可获得晶粒更细、性能更均一的靶材,具有潜在优势,尽管国外有公司称已经生产出粉末冶金坯制造的钽板,能够符合制造靶的要求,但目前仍未被广泛使用于市场,或许还存在一些技术瓶颈,相信随着研究进展,必将克服技术壁垒,制备出性能更优异的高纯钽溅射靶材。
参考文献:
[1]潘伦桃,李彬,郑爱国,等.钽在集成电路中的应用[].稀有金属,2003,27[1]:28-34.
[2]尚再艳,江轩,李勇军,等.集成电路制造用溅射靶材[].稀有金属,2005,29[4]:475-477.
[3]宗兆翔,杜磊,庄奕琪,等.超大规模集成电路互连电迁移自由体积电阻模型[].物理学报,2005,54[12]:5872-5877.
[4]王俊忠,吉元,王晓冬,等.Al互连线和Cu互连线的显微结构[J].物理学,2007,56[1]:371-375.
[5]杨谦.高纯钽形变与退火过程中微观组织结构及织构演变的研究[D].重庆:重庆大学,2010.
[6]罗俊锋,丁照崇,董亭义,等.钌金属溅射靶材烧结工艺研究[J].粉末冶金工业,2012,22[1]:28-31.
[7]刘贵材,娄燕雄.钽铌译文集[M].长沙:中南大学出版社,2009.118-157.
[8]仙田真一郎,福岛笃志.钽溅射靶[P].中国专利:103069044 A,2013-04-24.
[9]Christopher A, Michaluk,Gilbertsville,et al. Power Metallurgy Sput-tering Targets and Methods of Producing Same[P].US:7067197 B2,2006-06-27.
[10]陈明,朱晓光,王欣平,等.Ta晶粒细化工艺及组织、织构的研究印.热加工工艺,2010,39[8]:26-28.
[11]邓超.多晶高纯钽板轧制变形与退火行为研究[D].重庆:重庆大学,2014.
[12]储志强.国内外磁控溅射靶材的现状及发展趋势[].金属材料与冶金工程,2011,[4]:44-49.
[13]罗俊峰.粉末冶金靶材的制备与应用[].中国金属通报,2011,[31]:40-41.
[14]张青来,贺继弘.粉末冶金高纯铬和铬合金溅射靶材烧结工艺研究[].金属成型工艺,2006,21[6]:83-85.
[15]吕建玲.钽铌资源现状及我国钽铌工业的发展[J].环球市场信息导报,2013,16:13.
[16]张春恒,吴红,李桂鹏,等.一种应用于半导体的钽板制备工艺研究[].材料开发与应用,2010,[6]:29-32.
(注,原文标题:高纯钽溅射靶材制备工艺进展_郑金凤)
相关链接